【導讀】數字 IC 的封裝選項(以及相關(guān)的流行詞和首字母縮略詞)繼續成倍增加。微處理器、現場(chǎng)可編程門(mén)陣列 (FPGA) 和專(zhuān)用定制 IC (ASIC) 等高級數字 IC 以多種封裝形式提供。
數字 IC 的封裝選項(以及相關(guān)的流行詞和首字母縮略詞)繼續成倍增加。微處理器、現場(chǎng)可編程門(mén)陣列 (FPGA) 和專(zhuān)用定制 IC (ASIC) 等高級數字 IC 以多種封裝形式提供,例如:QFN——四方扁平無(wú)引線(xiàn); FBGA——細間距球柵陣列; WLCSP——晶圓級封裝; FOWLP——扇出晶圓級封裝; fcCSP——倒裝芯片級封裝;和 FCBGA——倒裝芯片球柵陣列封裝。
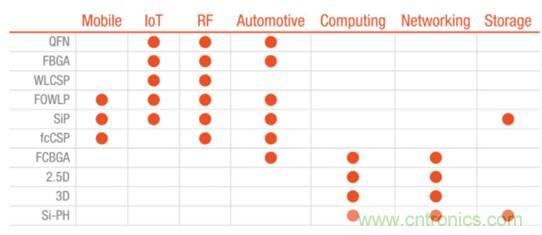
先進(jìn)半導體器件的封裝類(lèi)型和市場(chǎng)用途。 (表:格羅方德)
將多個(gè)芯片封裝在一起的選項包括系統級封裝、多芯片模塊、芯片級、小芯片、異構、2.5D 和 3D 堆疊等。正在開(kāi)發(fā)的多芯片量子處理器可以解決容錯量子計算機的關(guān)鍵擴展挑戰。共同封裝光學(xué)器件 (CPO) 或封裝光學(xué)器件 (IPO) 正在出現,它們將光學(xué)器件和開(kāi)關(guān)硅集成在同一封裝中,從而在曾經(jīng)不相交和獨立的技術(shù)之間產(chǎn)生協(xié)同作用,并節省大量功率。

多芯片封裝技術(shù)的演進(jìn)。(圖片:Cadence 設計系統)
小芯片、MCM 和 SiP
基于小芯片(Chiplet)的設計、多芯片模塊 (MCM) 和系統級封裝 (SiP) 是或可以是異構集成的形式,在定義這三種封裝風(fēng)格時(shí)存在非常大的灰色區域。一家公司的基于小芯片的設計可能被另一家供應商稱(chēng)為 MCM,而 MCM 和 SiP 通常被歸為同一類(lèi)別。下面回顧了一些細微差別。
小芯片是經(jīng)過(guò)測試的 IP 功能的物理實(shí)現,具有在硅晶片上制造的標準通信接口,可通過(guò)提高制造產(chǎn)量和跨應用程序的可重用性來(lái)降低成本。給定解決方案中的小芯片可以具有不同的工藝節點(diǎn)。小芯片提供標準功能,使設計人員能夠專(zhuān)注于設計中的獨特 IP。結果被稱(chēng)為“偽 SoC”,其設計速度比完全集成的 SoC 解決方案更快、成本更低?;谛⌒酒慕鉀Q方案通常不包括無(wú)源設備或其他“非硅”設備。小芯片解決方案的一個(gè)例子可以是當今的一些微處理器,其中處理器內核和 I/O 駐留在通用封裝中的不同硅芯片上。
MCM 最初僅集成多個(gè)芯片,不包括無(wú)源器件或其他組件。 MCM 中的芯片是“完整”的 IC,例如處理器、GPU 和 RF 部分,而不是更簡(jiǎn)單的單功能小芯片。隨著(zhù)概念的發(fā)展,MCM 的尺寸越來(lái)越大并集成了額外的組件,于是 SiP 誕生了。 MCM 和 SiP 之間的主要區別在于 MCM 不必是一個(gè)完整的系統。根據定義,SiP 是單個(gè)封裝中的系統。
MCM 是封裝中緊密耦合的子系統或模塊。 SiP將多個(gè) IC 以及支持的無(wú)源器件集成到單個(gè)封裝中。與 MCM 一樣,SiP 可以使用來(lái)自最佳單個(gè)工藝或工藝節點(diǎn)的硅來(lái)優(yōu)化性能并實(shí)現所需的集成。SiP 被設計為一個(gè)完整的系統并用作單個(gè)組件。

系統級封裝 (SiP),有時(shí)稱(chēng)為多芯片模塊 (MCM),將多個(gè) IC 和無(wú)源器件集成到單個(gè)封裝中。 (圖片:Octavo 系統)
2.5D 和 3D 封裝
使用硅通孔 (TSV) 互連多個(gè)管芯通常被認為是 MCM 或 SiP 與 2.5D 封裝器件之間的區別。 TSV 為 MCM 和 SiP 中的有機基板提供了高密度替代品。使用 TSV 可以獲得 3D 封裝的一些好處,而沒(méi)有與全 3D 方法相關(guān)的挑戰和成本。簡(jiǎn)而言之,與傳統的 MCM 或 SiP 解決方案相比,將多個(gè)管芯放置在具有非常細間距 TSV 的中介層上會(huì )產(chǎn)生互連和更好的重量、尺寸和功率特性。
全3D IC則是更進(jìn)一步,使用 TSV 在垂直維度上堆疊。它可以產(chǎn)生更小和更高性能的解決方案。 3D 封裝是另一種形式的垂直集成,指的是使用引線(xiàn)鍵合和倒裝芯片等互連方法進(jìn)行 3D 集成。 3D 封裝可分為 3D 系統級封裝 (3D SiP)、3D 晶圓級封裝 (3D WLP) 和 3D 層疊封裝 (3D PoP)。與 2.5D 封裝相比,各種形式的 3D 封裝都有一些缺點(diǎn),包括:
通過(guò)將芯片并排放置而不是垂直堆疊可以提高散熱性能。
3D 結構本質(zhì)上更復雜,修改或升級 2.5D 裝配通常更簡(jiǎn)單、更快。升級 2.5D 器件就像使用新的中介層或用改進(jìn)版本替換一個(gè)或多個(gè)芯片一樣簡(jiǎn)單。
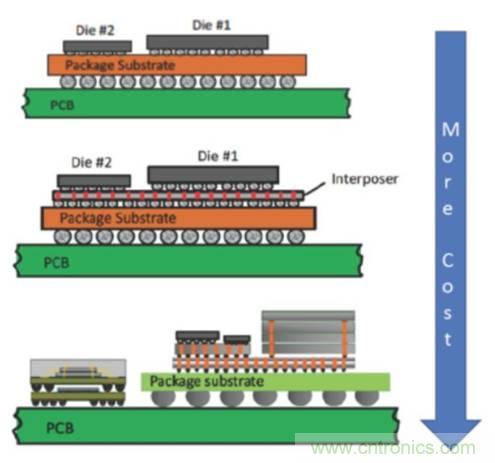
2D 封裝在封裝基板上的單個(gè)平面上安裝 2 個(gè)或更多裸片,2.5D 在裸片和封裝基板之間添加一個(gè)中介層,3D 堆疊則是在垂直維度進(jìn)行集成。 (圖片:美國宇航局)
晶圓級和芯片級
使用晶圓級封裝 (WLP),晶圓制造工藝擴展到包括晶圓切割之前的器件互連。大多數其他封裝首先進(jìn)行晶圓切割,然后將單個(gè)管芯放入塑料封裝中并連接焊料凸點(diǎn)。 WLP 在切割晶圓之前將封裝的底部和頂部輸出層以及焊料凸塊連接到 IC。由于封裝與裸片的尺寸基本相同,因此 WLP 是芯片級封裝 (CSP) 技術(shù)的一種形式。
WLP 用于需要盡可能最小的解決方案的應用,例如智能手機。然而,WLP 的局限性在于,由于封裝尺寸非常小,可以支持的觸點(diǎn)數量有限。在高度復雜和緊湊的系統中,扇出晶圓級封裝 (FO-WLP) 增強了標準 WLP 以克服有限的 I/O 功能。
與傳統封裝相比,FO-WLP 可實(shí)現更小的封裝尺寸以及改進(jìn)的散熱和電氣性能。盡管如此,FO-WLP 還是比 WLP 大,而且 FO-WLP 支持更多數量的觸點(diǎn),但不會(huì )增加芯片尺寸。在 FO-WLP 中,首先切割晶圓,然后將芯片精確地重新定位在載體晶圓上,每個(gè)芯片周?chē)加幸粋€(gè)扇出區域。模具成型,然后添加焊球。
光學(xué)封裝
高速數字網(wǎng)絡(luò )(例如超大規模數據中心)中的序列化-反序列化 (SerDes) 功能通常涉及基于硅的通信鏈路和基于光的鏈路之間的接口。隨著(zhù)光學(xué)引擎和開(kāi)關(guān)硅之間的距離減小,通道插入損耗也隨之下降,從而節省了大量功率。最接近的間距是通過(guò)共同封裝光學(xué)器件 (CPO) 實(shí)現的,其中接口的兩側都在一個(gè)封裝中。

共同封裝的光學(xué)器件具有最短的互連距離和最大的節能效果。 (圖片:思科系統)
正在開(kāi)發(fā) CPO 的兩項工作是車(chē)載光學(xué)聯(lián)盟 (COBO) 和共同封裝光學(xué)聯(lián)合開(kāi)發(fā)基金會(huì ) (CPO JDF)。COBO 已經(jīng)創(chuàng )建了一個(gè) CPO 工作組,專(zhuān)注于為 CPO 實(shí)施制定技術(shù)指南和標準。它由對在超大規模數據中心使用 CPO 感興趣的最終用戶(hù)和技術(shù)供應商組成。COBO 活動(dòng)主要對 CPO 實(shí)施所需的遠程激光源和光學(xué)連接感興趣,預計它將與其他 CPO 標準化活動(dòng)相輔相成。
Facebook 和微軟成立了CPO JDF,其主要考慮與 CPO 相關(guān)的系統集成問(wèn)題有關(guān)。 CPO JDF 發(fā)布了一份產(chǎn)品需求文檔 (PRD),描述了旨在提高網(wǎng)絡(luò )交換機密度和電源效率的 8x400G CPO 模塊。 PRD 要求使用 XSR(極短距離)接口。 XSR 針對封裝基板上的芯片到光學(xué)引擎 (D2OE) 接口和芯片到芯片 (D2D) 接口進(jìn)行了優(yōu)化,最大可達約 100 毫米 × 100 毫米。
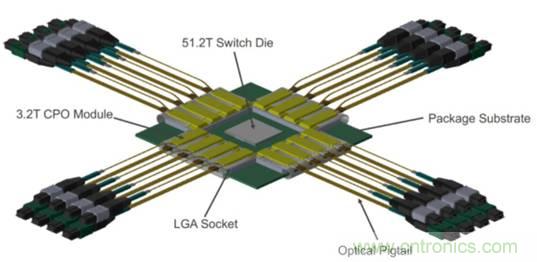
基于XSR接口規范的3.2T CPO模塊組裝。 (圖片:車(chē)載光學(xué)聯(lián)盟)
16 個(gè) XSR CPO 模塊將用于構建低功耗 51.2Tb/s 交換機。 PRD 定義了 CPO 模塊的兩種變體,一種支持 400GBASE-FR4(8 個(gè) Tx/Rx 光纖對),一種支持 400GBASE-DR4(總共 32 個(gè) Tx/Rx 光纖對)。
多芯片量子處理器
擴展量子計算機具有挑戰性。隨著(zhù)量子處理器尺寸的增加,制造良率下降。實(shí)現糾錯量子計算需要大量的量子位(qubit)。正在努力將多個(gè)較小的芯片連接到一個(gè)大規模的量子處理器中。這種多芯片方法有望簡(jiǎn)化大型量子處理器的創(chuàng )建,并支持該技術(shù)的可預測和加速擴展。
縮放是開(kāi)發(fā)容錯量子計算機的關(guān)鍵。預計今年晚些時(shí)候將測試一個(gè) 80 量子位的系統。將多芯片模塊技術(shù)應用于量子處理器可以產(chǎn)生足夠大的系統來(lái)運行實(shí)際應用,包括所需的糾錯。

多芯片量子處理器。 (圖片:Rigetti Computing)
概括
數字 IC、光互連和量子處理器的封裝選擇越來(lái)越多。先進(jìn)的封裝技術(shù)支持異構集成以及使用來(lái)自最佳單個(gè)工藝或工藝節點(diǎn)的 IC 來(lái)優(yōu)化性能并實(shí)現所需的集成。持續的封裝開(kāi)發(fā)對于實(shí)現從手機到超大規模數據中心的先進(jìn)系統解決方案非常重要。
免責聲明:本文為轉載文章,轉載此文目的在于傳遞更多信息,版權歸原作者所有。本文所用視頻、圖片、文字如涉及作品版權問(wèn)題,請電話(huà)或者郵箱聯(lián)系小編進(jìn)行侵刪。






