【導讀】上一篇文章中通過(guò)標準型且具有快恢復特性的SJ MOSFET的雙脈沖測試,介紹了“在橋式電路中,恢復特性可通過(guò)使用高速MOSFET來(lái)降低損耗,但是在某些情況下,即使使用高速MOSFET也無(wú)法降低導通損耗”。本文就其中一個(gè)原因即誤啟動(dòng)現象進(jìn)行說(shuō)明。
通過(guò)雙脈沖測試評估MOSFET的反向恢復特性
上一篇文章中通過(guò)標準型且具有快恢復特性的SJ MOSFET的雙脈沖測試,介紹了“在橋式電路中,恢復特性可通過(guò)使用高速MOSFET來(lái)降低損耗,但是在某些情況下,即使使用高速MOSFET也無(wú)法降低導通損耗”。本文就其中一個(gè)原因即誤啟動(dòng)現象進(jìn)行說(shuō)明。
什么是誤啟動(dòng)現象
誤啟動(dòng)是因MOSFET的各柵極電容(CGD,CGS)和RG引起的現象,在串聯(lián)2個(gè)MOSFET的橋式電路中,當位于開(kāi)關(guān)側的MOSFET導通(Turn-on)時(shí),在原本為OFF狀態(tài)的續流側MOSFET發(fā)生了不應發(fā)生的導通,導致直通電流流過(guò),損耗增大。
誤啟動(dòng)的發(fā)生機制
本圖與在“什么是雙脈沖測試?”中用于說(shuō)明的圖是同一幅圖,圖中給出了雙脈沖測試的基本工作。

從工作②轉換為工作③時(shí),高邊Q1的Drain-Source間電壓VDS_H從0V急劇變?yōu)閂i。由于此時(shí)產(chǎn)生的dVDS_H/dt(單位時(shí)間內的電壓變化) ,使電流流過(guò)CGD_H、CGS_H和RG_H。如果此電流導致CGS_H的電壓上升、VGS_H超過(guò)MOSFET的柵極閾值,則MOSFET將發(fā)生不應發(fā)生的導通。我們將該現象稱(chēng)為誤啟動(dòng),發(fā)生誤啟動(dòng)時(shí),高壓側Q1和低壓側Q2之間會(huì )流過(guò)直通電流。下圖是展示了因體二極管的反向恢復電流和誤啟動(dòng)而引發(fā)直通電流的示意圖。
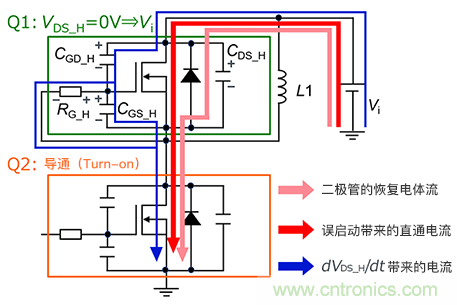
由于逆變器電路和Totem Pole PFC電路等是串聯(lián)了2個(gè)MOSFET的橋式電路,因此不僅會(huì )出現反向恢復損耗,而且還可能因誤啟動(dòng)引起的直通電流導致導通損耗增大。
上一篇文章中提到的評估中使用的R6030JNZ4(PrestoMOS™),已證實(shí)其導通損耗比其他快恢復型SJ MOSFET要小。這不僅僅是因為其恢復特性出色,更是因為對各柵極電容之比進(jìn)行了優(yōu)化,并采用了可抑制誤啟動(dòng)的結構。
關(guān)鍵要點(diǎn)
● 橋式電路中的誤啟動(dòng)是指由于MOSFET的VDS急劇變化引發(fā)VGS的波動(dòng),從而導致MOSFET發(fā)生意外導通的現象。
● 當誤啟動(dòng)引發(fā)了直通電流時(shí),導通損耗會(huì )增加,因此有時(shí)候即使恢復特性出色也未必能夠獲得理想的損耗降低效果。
推薦閱讀:






